 Search
Search


來源:新聲半導體 作者:新聲半導體 時間:2024-05-27

封裝技術在半導體行業中至關重要,它不僅保護芯片,還提供電氣連接和散熱路徑。按照不同的封裝形式和應用領域進行分類,半導體封裝技術主要包括:
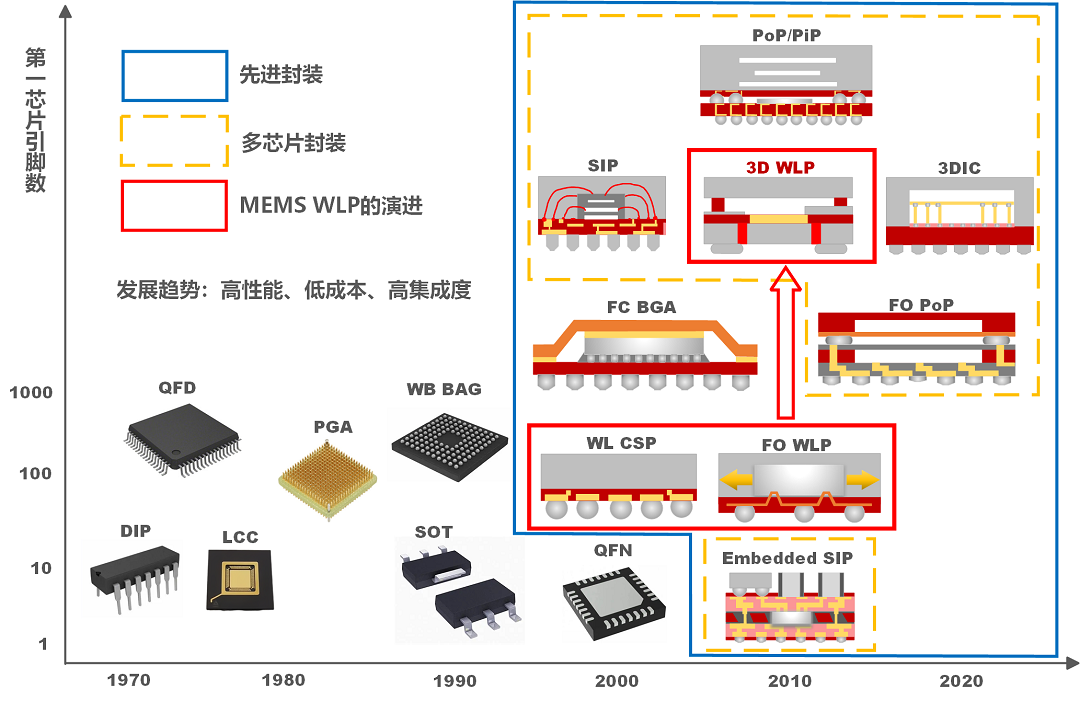
圖1. 封裝工藝演進
1. 硅通孔(Through Silicon Via, TSV)技術


通過在芯片或封裝的表面重新分配和布局互連線路,提供更加靈活和高效的電氣連接,支持多種I/O配置和高密度互聯需求。
3. 凸點制造或凸點工藝(Bumping)
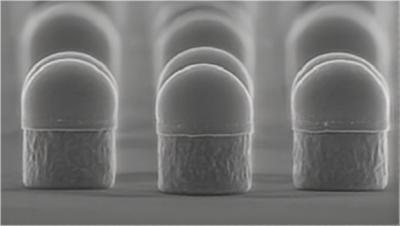
4. 晶圓鍵合(Wafer Bonding)技術


利用電解原理在導電物體表面沉積一層金屬或合金涂層。在WLP技術中,電鍍參與TSV的金屬填充,Bumping形成,RDL制造等。
BAW濾波器是具有三維機械結構(振動的諧振器單元)的射頻MEMS器件,其結構工作時需要穩定的外部環境。這樣的特征,決定了BAW濾波器的封裝與傳統IC封裝存在諸多不同,且工藝更加復雜。如果說IC封裝是平面二維的,WLCSP,FO-WLP等晶圓級封裝工藝,是為了集成更多的引腳;BAW濾波器封裝則是立體三維的,引腳之外,更重要的是提供密封的空腔,讓諧振器在穩定的環境中實現自由的振動,所以BAW需要“3D WLP“。
Avago的FBAR在2003年左右就實現了WLP技術 – Microcap,并且布局了核心技術專利Microcap,其核心是成型硅蓋Shaped Si Cap和金金鍵合Au-Au Bonding(US8232845B2)。彼時整個MEMS的晶圓級封裝技術還不是很完善,而傳統SAW濾波器也還在使用古老的陶瓷管殼以及打金線的封裝方式。Avago選擇了相對成熟的金屬環熱壓鍵合(Metal Diffusion路線)封裝,所使用的材料是金。Avago 的Microcap技術核心包含構筑于Cap Wafer上的TSV,形成空腔的硅凸點和凸環,用于鍵合及電連接的Au Gasket (墊圈結構)。通過TSV及硅凸點等方案的合理結合,在保證密封的同時實現了有效的電氣互聯。

Avago獨特的WLP技術Microcap對于后續20年FBAR的大規模商用功不可沒,這種全硅的方案給后道封裝帶來極大的便利,保證了Avago在模組方案中,能夠進行更高密度的集成。一份2019年的調研報告(Yole)顯示:Avago在其中高頻發射模組中(尺寸為7.22×6.23mm,厚0.76mm)集成了19顆FBAR濾波器,單顆濾波器面積僅為1mm2的1/2。

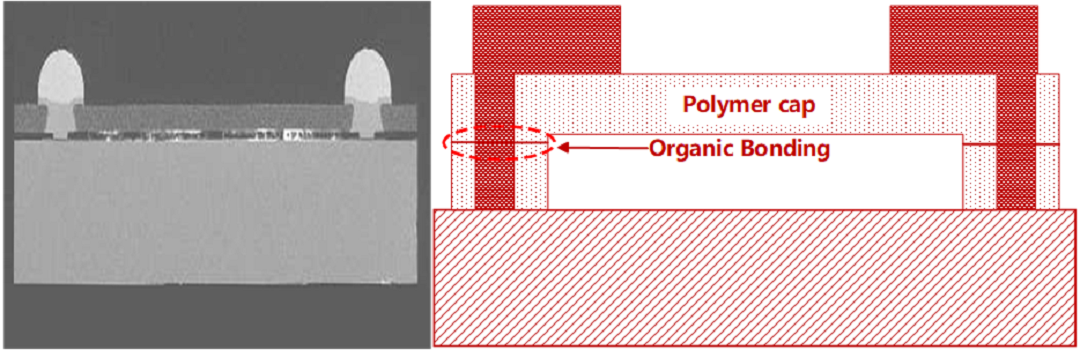
圖4. Qorvo: Polymer Cap + Organic Bonding

Newsonic:Raw Si Cap + Organic Bonding
新聲半導體(Newsonic)于2021年面向市場推出了原創的采用SiRoof封裝方案的D-BAW產品系列。其特點為完整硅帽(Raw Si Cap)+ 干膜有機鍵合 (Organic Bonding),并且新聲在中美布局了核心技術專利US20220103147A1和CN113556098B。SiRoof設計中對TSV的布局不同于常規WLP做法,將電氣互聯的TSV設置在器件的一側,而非Cap(硅帽)一側,這樣的設計意味著電流路徑無需穿越鍵合界面,從而有效避免了因鍵合界面殘余應力引起的潛在可靠性問題,可靠性等級與Avago一致,大幅增強了產品的穩定性和耐用性。相比于經多層光罩,多道工藝復雜加工的Microcap,新聲SiRoof晶圓只需一道光罩,像屋頂(Roof)一樣蓋在了有機鍵合層形成的墻上,整體縮短了制造周期,降低成本。

圖6. Newsonic雙面鍵合技術:Raw Si Cap + Organic Bonding
眾所周知,影像是全人類的旺盛需求,人們的生活被手機攝像頭徹底的改變了。1990年代,手機拍照技術開始逐漸發展并迅速普及,隨后智能手機攝像頭顆數和性能需求急劇攀升。

圖7. 網友調侃現代攝像頭是麻將牌
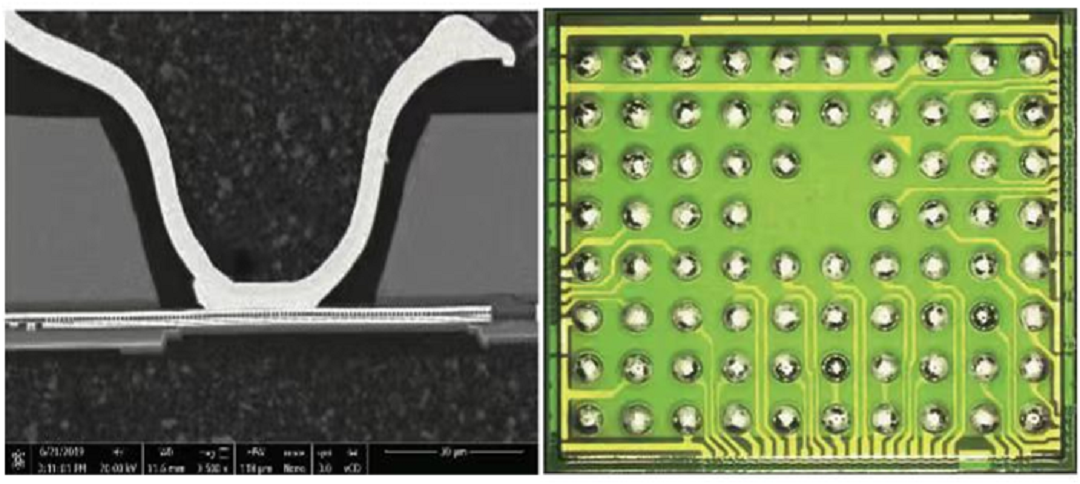
圖8. CIS WLP的現代以TSV為基礎的封裝形式[6]
巧合的是,BAW的WLP也有此類減小電氣互聯寄生、保障可靠性及密封性、和縮小尺寸的需求,新聲尋求到CIS WLP大規模制造龍頭合作方共同開發嘗試將CIS WLP直接嫁接到DBAW晶圓,沒想到完全兼容迅速成功,即SiRoof(Raw Si Cap + Organic Bonding)。隨后,雙方又合作攻克了窄邊框晶圓鍵合,復雜介質的刻蝕等工藝難點,在大批量生產中進一步提升了可靠性余量。
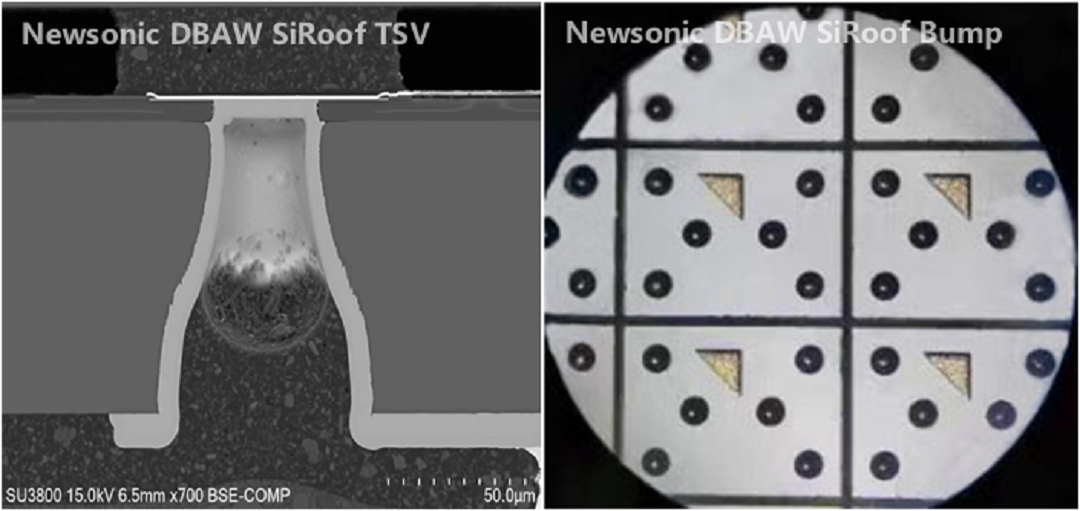
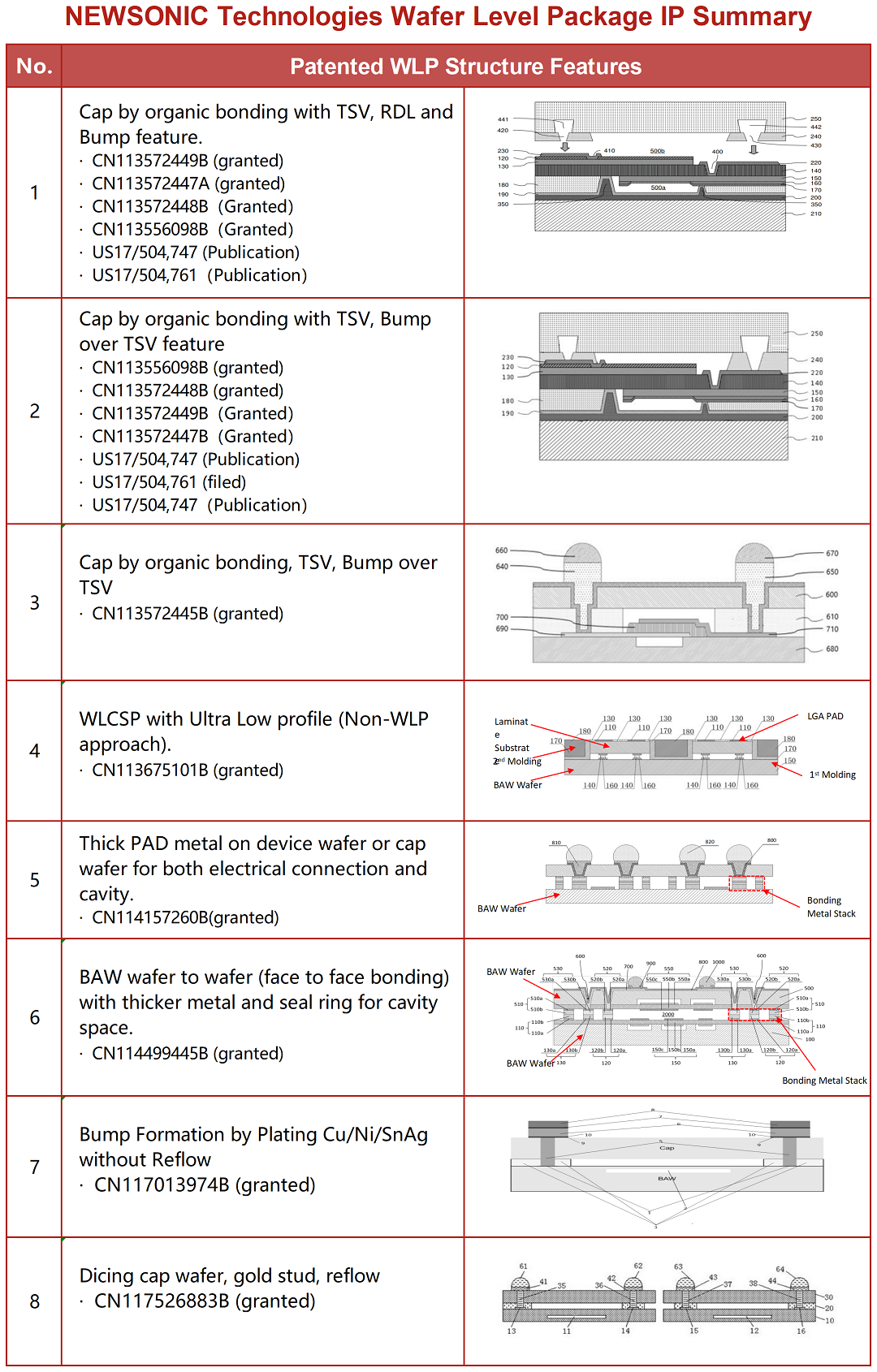

Avago、Skyworks、Qorvo等公司自由創新發展各自的BAW WLP技術,其中Avago和Sky主要基于“金屬鍵合”、Qorvo基于“雙層干膜”。Newsonic則站在CIS巨人肩膀上發展出先進穩定的SiRoof技術,充分糅合了CIS行業TSV的先進性、巨大產能的低成本,配合新開發的窄邊框有機鍵和技術、平坦未處理SiRoof材料,實現了自己的BAW WLP。
《三體》中關于技術爆炸理論有一段經典的描述:“……地球生命史長達十幾億年,而現代技術是在三百年時間內發展起來的,從宇宙的時間尺度上看,這根本不是什么發展,是爆炸!技術飛躍的可能性是埋藏在每個文明內部的炸藥,如果有內部或外部因素點燃了它,轟一下就炸開了……”。近二十年全球智能手機的發展不僅改變了人們的生活,也催生了“環智能手機”產業鏈的文藝復興式技術爆炸,射頻通訊行業和CIS行業都是其中一員。在這個璀璨的時代,我們都不光自己在發光,也能借到別人的光。
參考文獻
[1] United States Patent US9219464 - Bulk Acoustic Wave (BAW) Resonator Structure Having an Electrode with a Cantilevered Portion and a Piezoelectric Layer with Multiple Dopants: https://patentimages.storage.googleapis.com/a4/25/02/1e0ba32593084f/US9219464.pdf
[2] United States Patent US8232845B2 - Packaged Device with Acoustic Resonator and Electronic Circuitry and Method of Making the Same: https://patentimages.storage.googleapis.com/8f/92/b0/ed6ee6c47a65d3/US8232845.pdf



